
| Sommaire: |
![]()
Le Packaging :
un combat pour l'avenir
La packaging d'une mémoire représente la façon dont le die de la mémoire est "emballé" et la façon dont les connexions de ce même die sont interfacée avec l'extérieur. Le packaging, peu important lors des balbutiements de l'informatique, est devenu d'une grande importance avec l'augmentation des fréquences de fonctionnement. Mais voyons justement l'évolution des packaging depuis l'aube de l'informatique :
- les DIPs (Dual In-line Package)

 |
Au commencement etaient les DIPs (Dual In-line Package). Ces composants etaient des composants "through-hole". C'est a dire que contrairement aux composants actuels, ils comprenaient des connexions de l'autre coté du PCB ("A travers les trous"). Les composants DIPs sont donc les "puces" standard. Elles peuvent etre montées, soit directement sur le PCB, soit sur des supports, eux memes montés sur le PCB. Voyons maintenant l'interieur d'un DIP afin de voir comment le die est relié aux pins :
Bref, le die est fixé via un materiaux conducteur sur le "Spot Silver Plating". la liaison entre le die et les broches sont faites par l'intermédiaire d'un trés fin fil d'or.
- les SOJs (Small Outline J-Lead)

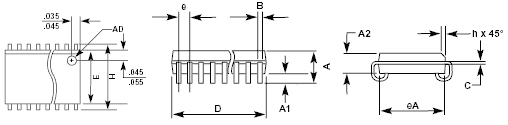 |
Les composants SOJ, trés utilisés aux temps des barettes SIMM et DIMM EDO ont répondus à un imperatif simple : il fallait monter les composants en surfaces pour permettre l'utilisation de PCB a plusieurs couches. Les industriels ont donc recourbés les broches d'un composant DIP en forme de "J" pour pouvoir monter ces composants en surface. Outre cette particularité, les composants SOJ sont aussi plus fins que leurs homologues DIP. Cependant, l'interieur du chip reste quasiment identique au DIP :
- les TSOPs (Thin Small Outline Package)

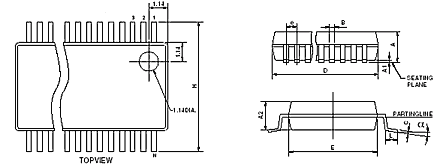 |
Aprés la solution "artisanale" du SOJ, est venu la solution "propre", le TSOP. Le TSOP a permis d'encore diminuer la dimension du package. Autre évolution, la masse métalique a été réduite par rapport au SOJ. En effet, cette masse provoque des interferences interdisant de fonctionner aux frequences requises aux début des TSOP (66 Mhz). Malheureusement, il reste toujours un cadre metallique empechant les frequences supérieures à environ 150 Mhz. Pour diminuer ce phénoméne, les constructeurs ont été contrait de descendre le voltage à 2.5 Volts pour la DDR-SDRAM en TSOP. Voici l'interieur d'un TSOP (il existe 2 types de TSOP, les "en long" et les "en large")
Comme on peut le voir, le cadre métallique sous le die est encore présent.
- les CSPs (Composant Size Package)

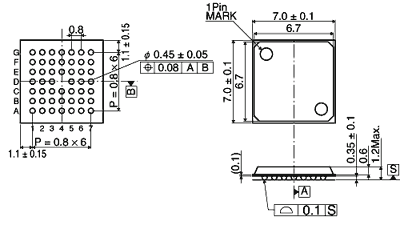 |
Les CSP sont des composants qui, comme leur nom l'indique, mesurent environ la taille du die qu'ils contiennent, c'est a dire très petite. Ils sont utilisés principalement sur les rambus. Or, qui dit CSP, dit aussi BGA (Ball Grid Array = matrice de contact en grille). En effet, la majorité des CSP sont constitués d'un die et d'une interface métallique (aïe) pour faire contact avec le BGA. Attention cependant, le BGA n'est qu'une architecture de contact et rien de plus. Des fabricants comme ACTRam (plus connu sous le nom Tonicom) ont ainsi tenté d'utiliser cette technologie avec plus ou moins de réussite (d'ailleurs ca marchait tellement bien qu'ils devaient programmer le SPD en CAS 4 voir en CAS 5 pour avoir une mémoire avec un minimum de fiabilité), probablement pour entraîner une confusion avec les modules Kingmax ayant le même aspect (mais pas vraiment les même performances). Marketing aidant, à coup de PC166, PC 183 et pourquoi pas PC12000, ces mémoires se sont vendues. Bien entendu, après avoir rencontré d'énormes problèmes, les utilisateurs ont finis par délaisser le produit, nous y reviendront. Aux dernières nouvelles, ACT/Tonicom aurait déposé le bilan, ce qui est une excellente nouvelle. Revenons a Kingmax, leur technologie TinyBGA faisant partie des composant CSP, passons donc au chapitre suivant pour étudier ça en détail.